| Location | UNSW – West Lab (Grey Area) |
| Type | Parallel plate, rf |
| Target Area | 100mm |
| Substrate size | 100mm |
| Gases | Ar, O2, CF4, CHF3, SF6, (CH4 & H2 will be available soon) |
| Rf power | 200 W |


| Location | UNSW – West Lab (Grey Area) |
| Type | Parallel plate, rf |
| Target Area | 100mm |
| Substrate size | 100mm |
| Gases | Ar, O2, CF4, CHF3, SF6, (CH4 & H2 will be available soon) |
| Rf power | 200 W |

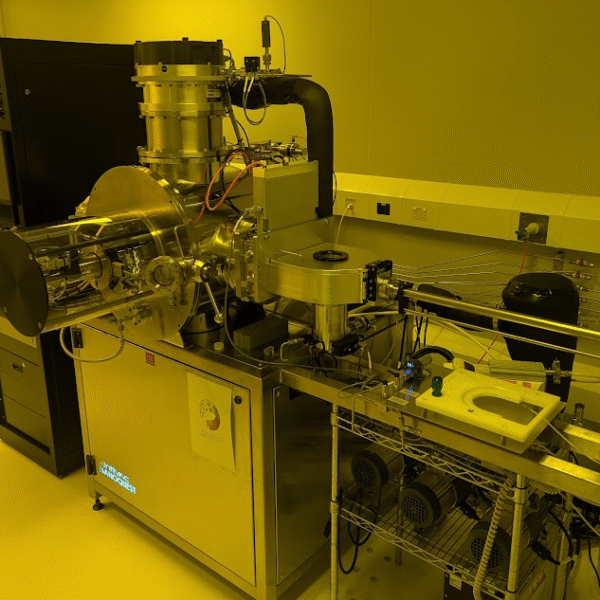
| Location | UTS |
| Description | Ion Beam Etcher, up to 600 eV impact energy |
| Wafer size | TBC |
| Gas available | Ar, O2 |


| Purpose | A dry etching tool that etches Si and Si-based materials with an inductive-coupled plasma source in the process chamber |
| Location | Plasma Etch & Deposition Bay, RPF Cleanroom |
| Material systems | Available gases are SF6, C4F8, CF4, CHF3, supported with argon, oxygen, and helium |
| Scale / volume | Either 4 inch or 6 inch carrier |
| Specs / resolution | Cryo processes; pseudo Bosch; resist masks; in-situ optical monitoring for etch stop |
| * Not an ANFF-supported tool; access is available – refer to Access Fees schedule |


| Purpose | A small plasma system that provides O2 plasma surface treatment such as wafer cleaning and photoresist / organic removal |
| Location | Plasma Etch & Deposition Bay, RPF Cleanroom |
| Material systems | Available gas is oxygen |
| Scale / volume | 10cm x 10cm samples |
| Specs / resolution | 50W RF power |
| * Not an ANFF-supported tool; access is available – refer to Access Fees schedule |

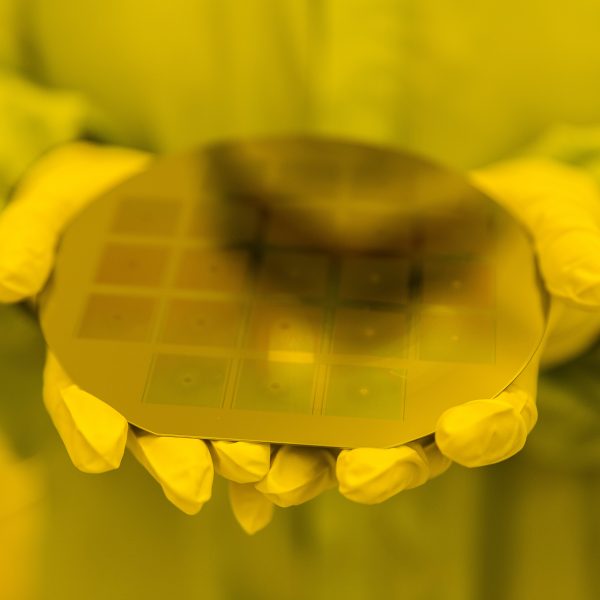
| Purpose | A compact reactive ion etching tool |
| Location | Plasma Etch & Deposition Bay, RPF Cleanroom |
| Material systems | Available gases are SF6, CF4, CHF3, supported with argon, oxygen, helium and nitrogen |
| Scale / volume | Accommodates 6 inch wafers |
| Specs / resolution | Optical emission spectroscopy endpoint detection |
| * Not an ANFF-supported tool; access is available – refer to Access Fees schedule |


| Purpose | Reactive ion etch system dedicated to oxygen and argon plasma processes |
| Location | Plasma Etch & Deposition Bay, RPF Cleanroom |
| Material systems | Available gases are argon and oxygen |
| Scale / volume | Accommodates 6 inch wafers |
| Specs / resolution | Used primarily for resist and sample cleaning |


| Location | UNSW – West Lab (Grey Area) |
| ICP Power | 1800 W |
| Target power | 600 W |
| Gases | Ar, O2, CHF3, CF4, SF6, C4F8, He |
| Bosch process | YES |
| Substrate size | 4” |
| Approved materials | Oxide, Silicon Nitride, Silicon/Polysilicon, Pyrex, PZT/PLZT, Ti/Pt, Cr |
| Electrostatic Clamp | YES |

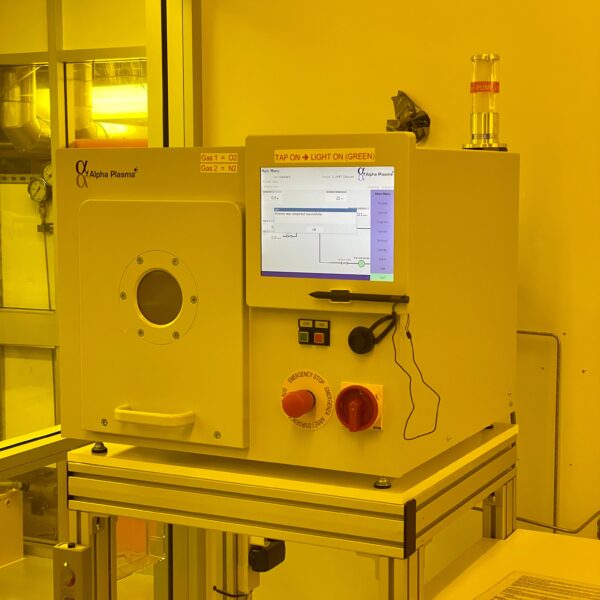
| Location | UNSW – West Lab (White Area) |
| Sample size | From small chips up to 8” |
| Chamber diameter | 235 mm |
| Microwave power | 2.45 GHz adjustable between 50 – 1200 watts |

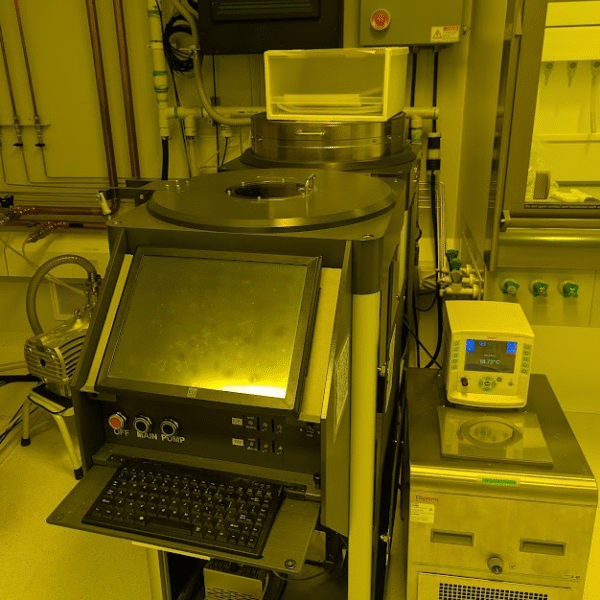
| Location | UTS |
| Description | 600W and 1200W ICP-RIE etchers with cold stage |
| Wafer size | 150 mm |
| Gas available | SF6, Cl2, Ar and O2 |


| Location | UTS |
| Description | 600W ICP and CCP power |
| Wafer size | 150 mm |
| Gas available | F2, Ar and O2 |


| Location | UNSW – Upper East Lab (Grey Area) |
| Sample size | From small chips up to 6” |
| Gases | SF6, CF4, CHF3, O2, Ar,C4F8, N2 |
| RF power | 0-300W |
| Processes available | Si deep and shallow, SiO2, SiNx, Ge, Al2O3 |
| Process Pressure range | 5-250mTorr |
| Chiller temperature range | 0-80°C |
| DC range | 0-500V |

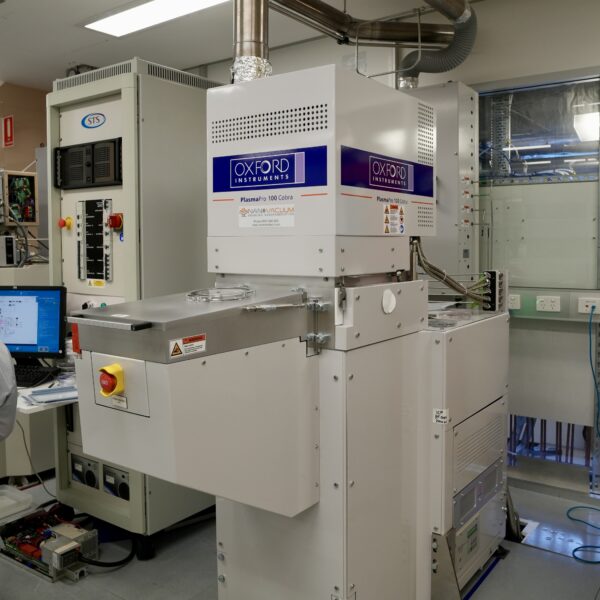
| Location | UNSW – West Lab (Grey Area) |
| ICP Power | 1800 W |
| Target power | 600 W |
| Gases | Ar, O2, CHF3, CF4, SF6, C4F8, He |
| Bosch process | YES |
| Substrate size | 4” |
| Electrostatic Clamp | YES |